FIB(聚焦离子束,Focused Ion beam)是将液态金属(大多数FIB都用Ga)离子源产生的离子束经过离子枪加速,聚焦后照射于样品表面产生二次电子信号取得电子像,或用强电流离子束对表面原子进行剥离,以完成微、纳米级表面形貌加工。通常是以物理溅射的方式搭配化学气体反应,有选择性的剥除金属,氧化硅层或沉积金属层。制备TEM截面样品就是其中重要用途。FIB取样位置精准,厚度在100nm以下,且成功率很高,所以经常用来制备薄膜、陶瓷等块体的TEM样品。此外,电子束无法穿透的微米级颗粒,也可用FIB制备一个薄样品再进行TEM测试。

FIB-SEM双束系统的原理图

FIB过程中样品、电子束、离子束三者的几何图
FIB主要工作模式是:成像、切割、沉积/增强刻蚀。


通过FIB实现对微球材料的表面、截面形貌和EDS线扫分析
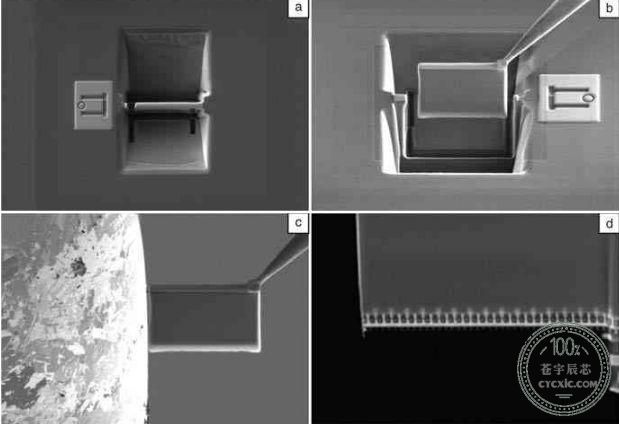
FIB制备TEM样品的步骤:1. 定位;2. 取出;3. 转移;4. 最终减薄
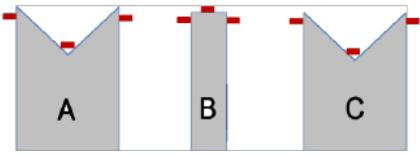
FIB铜网

FIB制备3D-AP样品

FIB制备三维图案
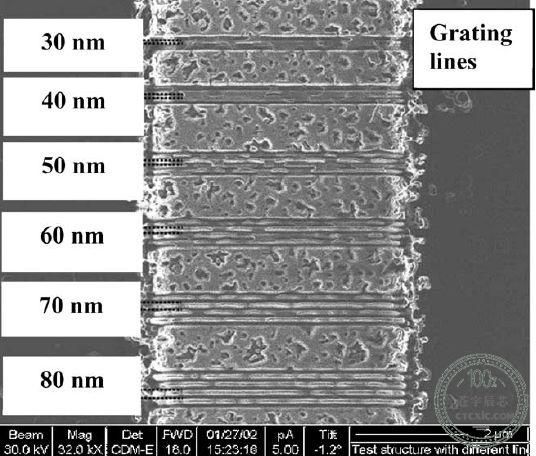
FIB刻蚀特殊的纳米光栅结构